PT-IGBT”лNPT-IGBT «Ќђ «≤…”√єµ≤џ’§їт∆љ√ж’§ЉЉ х£ђµЂ «Ћы√«µƒЈҐ’єЈљѕт≤ї“ї÷¬°£
°§PT-IGBT£Ї≤…”√∆љ√ж’§їт’яєµ≤џ’§£ђЉЉ хЄƒљшµƒ÷ч“™Јљѕт «њЎ÷∆‘ЎЅч„” ў√ьЇЌ”≈їѓN+їЇ≥е«ш°£
°§NPT-IGBT£Ї≤…”√∆љ√ж’§їт’яєµ≤џ’§£ђЉЉ хЄƒљшµƒ÷ч“™Јљѕт «Љх–°–Њ∆ђЇсґ».°£
PT”лNPTљбєє”л‘≠јнґ‘±»
1£ЃPT-IGBT
ЌЉ1 µЉ …ѕ «PT–Ќ1GBT–Њ∆ђµƒљбєєЌЉ£ђЌЉ2(c) «∆дµЉµз‘≠јн°£ЋщќљPT£®Punch Through£ђі©Ќ®–Ќ£©£ђ «÷Єµз≥°і©ЌЄЅЋN-∆ѓ“∆«ш£®ЌЉ1÷–Ґџ)£ђµз„””лњ’—®µƒ÷ч“™їгЇѕµг‘ЏN“ї«ш[ЌЉ1(c)]°£
NPT‘Џ µ—й “ µѕ÷µƒ ±Љд(1982 ƒк)“™‘з”ЏPT(1985)£ђµЂЉЉ х…ѕµƒ‘≠“т єµ√PTєжƒ£…ћ”√їѓµƒ ±Љд±»NPT‘з£ђЋщ“‘µЏ1іъIGBT≤ъ∆Ј“‘PT–Ќќ™÷ч°£
ЌЉ1 N–ЌIGBTµƒµд–Ќљбєє
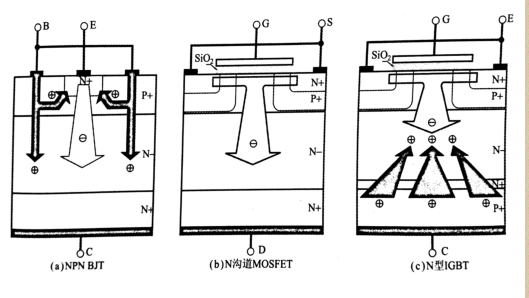
ЌЉ2 »э÷÷ЊІћеє№µƒµЉµз‘≠јн
PT-IGBTЇ№Ї√µЎљвЊцЅЋIGBTµƒг≈Ћшќ ћв£ђµЂ «–и“™‘цЉ”Ќв—”≤гЇсґ»£ђЉЉ хЄі‘”£ђ≥…±Њ“≤Єя°£IGBT–Њ∆ђ÷–µƒЌв—”≤г”лµз—єєжЄс «÷±љ”ѕаєЎµƒ£ђµз—єєжЄс‘љЄя°ҐЌв—”≤г‘љЇс£ђIZOOV°Ґ2000VµƒPT-IGBTЌв—”≤гЇсґ»Ј÷±ріпµљЅЋ100¶ћmЇЌ200¶ћm°£2£ЃNPT-IGBT
ЋщќљNPT£®Non-Punch Through£ђЈ«і©Ќ®£©£ђ «÷Єµз≥°√ї”–і©ЌЄN-∆ѓ“∆«ш£ђєє»зЌЉ3Ћщ Њ°£NPTµƒїщ±ЊЉЉ х‘≠јн «»°ѕыN ЃїЇ≥е«ш£®ЌЉ1÷–µƒҐ№)£ђ÷±љ”‘ЏЉѓµз«ш£®ЌЉ1÷–µƒҐЁ£©„Ґ»лњ’ЉдµзЇ…–ќ≥…Єя„и«ш£ђµз„””лњ’—®µƒ÷ч“™їгЇѕµгїї≥…ЅЋP ЃЉѓµз«ш°£’вѕоЉЉ х”÷±ї≥∆ќ™јл„”„Ґ»лЈ®°Ґјл„”≤ф‘”є§“’°£
ЌЉ3 ∆љ√ж’§”лєµ≤џ’§µƒљбєє Њ“вЌЉ(NPT–Ќ)
3£ЃPT-IGBT”лNPT-IGBT…ъ≤ъє§“’”лЉЉ х–‘µƒ«ш±рPT”лNPT–ЌIGBT «ƒњ«∞µƒ÷чЅч≤ъ∆Јја–Ќ£ђ600V µз—єєжЄсµƒIGBTїщ±Њ…ѕ «PT–Ќ£ђ600v“‘ѕ¬‘т»Ђ «PT–Ќ°£ґю’я‘Џ…ъ≤ъє§“’”лЉЉ х–‘ƒ№…ѕµƒ≤о±р≤ќЉы±н 1°£
±н 1 PT-IGBT”лNPT-IGBTµƒ≤о±р
| ѕоƒњ | PT-IGBT–Њ∆ђ | NPT-IGBT–Њ∆ђ | |
| …ъ≤ъє§“’”л–Њ∆ђљбєє | ‘≠Ѕѕfµ•ЊІєи£© | µЌµз„и¬ µƒP+µ•ЊІєи£®…ъ≥…P+±≥ЈҐ…д«ш£© | Єяµз„и¬ µƒN-µ•ЊІєи£®…ъ≥…N-∆ѓ“∆«ш£© |
| Ќв—”є§“’ | –и“™ | ≤ї–и“™ | |
| MOSљбєє | ‘ЏЌв—”≤г÷– | ‘Џµ•ЊІєи÷– | |
| –Њ∆ђЉх±°є§“’ | їщ±Њ≤ї–и“™£®ќ™ЅЋ±£÷§µз—єєжЄс£© | –и“™£®”–јы”ЏћбЄя–‘ƒ№£© | |
| јл„”„Ґ»лє§“’ | ≤ї–и“™£®P+±≥ЈҐ…д«ш“—Њ≠…ъ≥…£© | –и“™£®…ъ≥…P+±≥ЈҐ…д«ш£© | |
| Єяƒ№јл„”Јш’’є§“’ | –и“™£®÷–„”°Ґµз„”µ»£©£®ƒњµƒ «ћбЄяњ™єЎЋўґ»£© | ≤ї–и“™ | |
| ≥…±Њ | 100% | ‘Љ75& | |
| ЉЉ х÷Є±к”л–‘ƒ№ | ±•ЇЌ—єљµ | µЌ£ђЄЇќ¬ґ»ѕµ э | Єя£ђ’эќ¬ґ»ѕµ э |
| њ™єЎє¶Їƒ | µЌ | Єя | |
| єЎґѕє¶Їƒ | Єя£ђ ’ќ¬ґ»µƒ”∞ѕміу | µЌ£ђ №ќ¬ґ»µƒ”∞ѕм–° | |
| єЎґѕ ±Љд | ≥§£®±•ЇЌ—єљµ÷Є±кѕаЌђ ±£© | ґћ£®±•ЇЌ—єљµ÷Є±кѕаЌђ ±£© | |
| Ќѕќ≤µзЅч | ґћ£ђ №ќ¬ґ»µƒ”∞ѕміу | ≥§£ђ №ќ¬ґ»µƒ”∞ѕм–° | |
| г≈Ћш | “„≥цѕ÷£ђњєґћ¬Јƒ№Ѕ¶»х | ≤ї“„≥цѕ÷£ђњєґћ¬Јƒ№Ѕ¶«њ | |
| —©±јїчі© | њє—©±јїчі©ƒ№Ѕ¶µЌ | њє—©±јїчі©ƒ№Ѕ¶Єя | |
| ≤ҐЅ™ | Єі‘”£ђ±•ЇЌ—єљµ÷Є±к–и“™≈дґ‘ | »Ё“„£ђ±•ЇЌ—єљµ÷Є±к≤ї“їґ®–и“™≈дґ‘ | |
PT”лNPT…ъ≤ъє§“’µƒ«ш±р»зѕ¬:
°§PT-IGBT–Њ∆ђµƒ…ъ≤ъі”Љѓµз«ш£®P+±≥ЈҐ…д«ш£©њ™ Љ£ђѕ»‘Џµ• ЊІ єиµƒ±≥√ж…ъ≥…µЌ≤ф‘”µƒP+ЈҐ…д«ш£ђ»їЇу”√Ќв—”є§“’‘Џµ•ЊІєиµƒ’э√ж“јіќ…ъ≥…N ЃїЇ≥е«ш°ҐMOSљбєє°£
°§NPT-IGBT–Њ∆ђµƒ…ъ≤ъі”їщ«ш(N-∆ѓ“∆«ш)њ™ Љ£ђѕ»‘ЏN–Ќµ• ЊІ єиµƒ’э√ж…ъ≥…MOsљбєє£ђ»їЇу”√—–ƒ•Љх±°є§“’і”±≥√жЉх±°µљ IGBT µз—єєжЄс–и“™ LµƒЇсґ»£ђ‘ўі”±≥√ж”√јл„”„Ґ»лє§“’…ъ≥…Љѓµз«ш°£